IT之家 12月5日消息,根據外媒tomshardware消息,Twitter用戶@VadimYuryev曬出了蘋果M1 Max芯片的核心實拍照片,首次展現了真實的結構。與蘋果官方公布的渲染圖不同,這款芯片邊緣部分還有較大的一部分區域,沒有在渲染圖中顯示。這名用戶表示,僅需將這塊芯片翻轉,便可以與同款芯片互聯,組成MCM多芯片封裝架構,進一步提高性能。
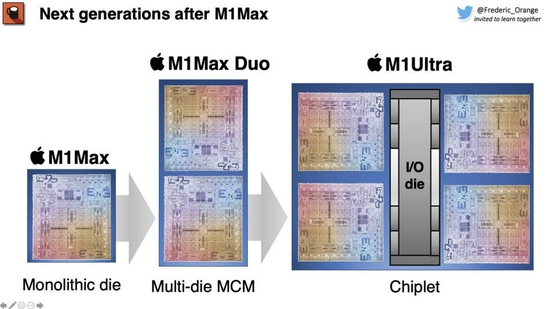
IT之家獲悉,蘋果目前的M1 Max芯片內含10顆CPU核心,24或32個GPU內核,采用臺積電5nm制程工藝制造,擁有高達570億個晶體管。如果蘋果這款芯片能夠多片封裝在一起,有望實現更加強大的性能,并且節約開發成本,無需重新設計。
目前僅發現M1 Max有著額外的集成電路,可以用于互聯,而M1 Pro系列芯片則沒有發現隱藏的部分,核心實拍照片與官方渲染圖一致。
如果蘋果M1 Max芯片能夠實現多片封裝,將可以支持128GB內存,內存帶寬也可以擴展至800Gb/s,可以用于圖形工作站等用途,同時耗電量相比傳統方案大大降低。

本站內容除特別聲明的原創文章之外,轉載內容只為傳遞更多信息,并不代表本網站贊同其觀點。轉載的所有的文章、圖片、音/視頻文件等資料的版權歸版權所有權人所有。本站采用的非本站原創文章及圖片等內容無法一一聯系確認版權者。如涉及作品內容、版權和其它問題,請及時通過電子郵件或電話通知我們,以便迅速采取適當措施,避免給雙方造成不必要的經濟損失。聯系電話:010-82306118;郵箱:aet@chinaaet.com。

