1965 年,英特爾聯合創始人戈登·摩爾預測,芯片上的晶體管數量大約每兩年翻一番,成本上升幅度很小。這一預測被稱為摩爾定律,如圖 1 所示。器件上的晶體管或組件越多,每個器件的成本就會降低,而每個器件的性能就會提高。

圖 1:“將更多組件塞進集成電路”的原始圖表
在過去兩年中,由 COVID-19 大流行引發的世界數字化速度飆升,而半導體行業及其創新促成了這種增強的轉型。
英特爾首席執行官 Pat Gelsinger 分享道:“技術對人類來說從未像現在這樣重要。一切都在變得數字化,而我們擁有四個關鍵的superpowers 。 ” 分別是無處不在的計算、云到邊緣的基礎設施、無處不在的連接和人工智能——這將超越和改變世界。
目前,我們認為對計算的需求沒有盡頭,更多的計算繼續推動行業進行更多創新。例如,世界每天產生近 270,000 PB的數據。我們預計,到本十年末,我們所有人平均將擁有 1 petaflop的計算量和 1 PB 的數據,距離不到 1 毫秒。 這種對計算能力越來越強的需求是推動行業保持摩爾定律步伐的動力。
40 多年來,英特爾工程師不斷創新,將越來越多的晶體管擠入更小的芯片上,以保持摩爾定律的步伐。在 2010 年代中后期,業界曾多次預測“摩爾定律已死”。套用一句名言,我覺得摩爾定律消亡的報道被夸大了。創新并未消亡,我們將一如既往地通過創新——工藝創新、封裝創新和架構創新來維持摩爾定律。一如既往,這將是一個挑戰——英特爾將迎接挑戰。
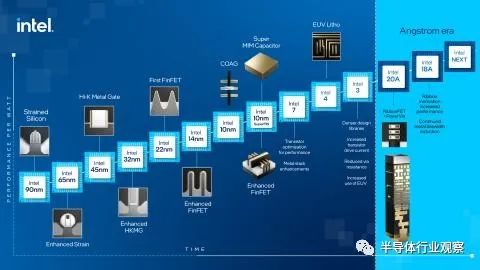
圖 2:隨時間推移的晶體管創新
今日創新:制程
英特爾在追求摩爾定律的基礎工藝創新方面有著悠久而豐富的歷史,如圖 2 所示。在芯片上的特征縮小到原子尺寸的過程中,英特爾工程師和科學家不斷面臨挑戰——然后克服。憑借高 k 金屬柵極技術、三柵極 3D 晶體管和應變硅等發明,英特爾始終如一地提供突破性技術,以跟上摩爾定律的步伐。到 2000 年代后期,隨著物理尺寸的不斷縮小,業界意識到需要其他創新領域來跟上步伐,包括材料科學、新工藝架構和設計技術協同優化 (DTCO)。
英特爾下一個偉大的架構創新是 RibbonFET,這是我們實現的環柵 (GAA) 晶體管,這將與Intel 20A工藝 一起推出。RibbonFET 代表了我們自 FinFET 以來的第一個新晶體管架構。RibbonFET 在更小的占位面積內以相同的驅動電流提供更快的晶體管開關速度。同時,我們還提供業界首個背面供電架構 PowerVia。以前,電源來自芯片頂部,并與信號互連“競爭”。通過分離電源和信號,您可以更有效地使用金屬層,因為需要做出的權衡更少。這會提高性能。下一代極紫外 (EUV) 光刻技術,即高數值孔徑或“High NA”,進一步提高了分辨率并減少了誤差,通過增加設計規則的靈活性來降低流程復雜性。英特爾與 ASML 和其他生態系統合作伙伴密切合作,率先將這項技術投入大批量生產。
這些例子只是開始。在 Intel 20A 和 Intel 18A 引入RibbonFET 和 PowerVia 之后,英特爾新的后續工藝節點已經在開發中,這些工藝在功率、性能和密度方面提供了額外的收益。這些收益是通過多項創新實現的,包括后端金屬電阻和電容的改進、晶體管架構和庫架構的改進。正如我們在 2021 年 7 月所說,隨著我們實施這些創新和其他創新,我們預計到 2024 年實現晶體管性能比,到 2025 年則能實現領先地位。

圖 3:隨時間推移的封裝創新
今日創新:封裝
封裝的作用及其對摩爾定律縮放的貢獻正在演變。直到 2010 年代,封裝的主要作用是在主板和硅片之間路由電源和信號,并保護硅片。那個時代的每一次演變——從引線鍵合和引線框架封裝,到陶瓷基板上的倒裝芯片技術,再到有機基板的采用和多芯片封裝的引入——都帶來了連接數量的增加。這些連接支持硅中的更多功能,這是摩爾定律縮放所需的。封裝是實現摩爾定律好處的載體。(參見圖 3。)
展望未來,隨著我們進入先進封裝時代,我們看到我們的封裝帶來了晶體管密度的提升。甚至 Gordon 本人也理解封裝的重要性,并在他的原始論文中說:“用單獨封裝和互連的較小功能構建大型系統可能會更經濟。” 隨著我們進入高級封裝時代,這些 2D 和 3D 堆疊技術為架構師和設計師提供了進一步增加每個器件的晶體管數量的工具,并將有助于摩爾定律所需的微縮。
例如,我們的嵌入式多芯片互連橋 (EMIB) 技術允許設計人員再次套用 Gordon 的話——在封裝中“塞入更多晶體管”。這使設計人員能夠遠遠超過單片硅的尺寸限制。EMIB 還支持在一個封裝中使用來自不同工藝節點的硅片,從而允許設計人員為該特定 IP 選擇最佳工藝節點。英特爾的 Foveros 技術建立了業界第一個有源邏輯硅堆疊能力,創造了在三維空間中添加邏輯晶體管的能力。這兩項成就都代表了我們如何在每個封裝中提供越來越多的晶體管的方式發生了顯著變化。結合起來,這些技術可以實現前所未有的集成水平。例如,老橋,
我們即將推出的 Foveros 演進——Foveros Omni 和 Foveros Direct——提供了新的擴展、新的互連技術和新的混合搭配功能。
Foveros Omni 進一步將互連間距擴大到 25 微米,并增加了多個基礎芯片的選項。與 EMIB 相比,密度大約增加了 4 倍,同時也擴展了我們混合和匹配基礎瓷磚的能力。
Foveros Direct 引入了無焊直接銅對銅鍵合,可實現低電阻互連和亞 10 微米凸點間距。由此產生的互連能力為功能性芯片分區開辟了新的視野,這是以前無法實現的,并且能夠垂直堆疊多個有源硅層。隨著這些技術(和其他技術)進入市場,會給芯片設計師維持摩爾定律提供支持。

圖 4:主要研究領域
天的創新:組件研究
正如我之前提到的,我相信創新以及最終用戶的需求推動了摩爾定律的發展。英特爾的組件研究專注于三個關鍵研究領域(參見圖 4),為未來更強大的計算提供基本構建模塊。我們正在進行一整套研究,這讓我們有信心在未來十年或更長時間內保持摩爾定律。推動摩爾定律的未來創新僅限于我們的想象力。
最近,在 2021 年 IEEE 國際電子設備會議 (IEDM) 上,我們概述了未來創新的幾個領域。
我們研究的一個重點是在同一領域提供更多晶體管的擴展技術。這包括創新的光刻技術進步,例如分子定向自組裝 (DSA),以提高線邊緣粗糙度和邊緣放置精度。 我們還研究只有幾個原子厚的新型材料,以制造更薄的晶體管,從而縮小它們的整體尺寸。
除了這些創新之外,我們正在建立可行的能力,可以將晶體管垂直堆疊在同一塊硅片上,或者使用先進的封裝技術(如混合鍵合和不斷減小的垂直界面間距)作為小芯片。以新材料、晶體管架構創新、光刻技術突破和封裝發明為自由度,設計師只會受限于他們的想象力。
隨著我們通過擴展實現更強大的計算,我們需要為硅帶來新的功能并擴展其極限。通過集成新材料,我們可以更高效地提供電力并滿足對內存的更大需求。我們還在研究鐵電和反鐵電材料,它們可以根據不同類型的物理特性保持其電荷狀態,而無需依賴低泄漏晶體管。我們發明了一種基于鐵電材料獨特物理特性的新型存儲器架構,通過使用一個具有多個并聯電容器的存取晶體管來顯著提高位密度。鐵電存儲器是高速緩存和主存儲器之間嵌入式密集存儲器層的有力候選者。
我們也在擁抱量子領域,不僅僅是以量子計算的形式,而是通過探索物理和材料科學中的新概念,這些概念有朝一日可能會徹底改變世界的計算方式。摩爾定律的長期發展需要克服當前基于 CMOS 計算的功耗要求的指數增長。 為了繼續,將需要在環境室溫下擴展在材料(稱為量子材料)中使用量子效應的超低功耗解決方案。
在 2021 年的 IEDM 上,我們報告了超越 CMOS 器件研究的一個巨大里程碑:磁電自旋軌道邏輯器件的首次功能演示,其讀寫組件在室溫下正常工作。自旋軌道輸出模塊和磁電輸入模塊都集成在器件中,通過施加的輸入電壓實現磁化狀態反轉。憑借其實現更高功能多數門(與 NAND 和 NOR 相比)的能力,形成超低功耗多數門的三個 MESO 器件可以實現 1 位加法器,否則需要 28 個 CMOS 晶體管。

圖 5:摩爾定律每個器件的晶體管數量:過去、現在、未來
綜上所述
摩爾定律預測每個器件的晶體管數量將每兩年翻一番。摩爾定律一直是由創新驅動的。圖 5 展示了我們回顧過去、現在和未來時每個器件的晶體管數量。在最初的 40 年里,收益主要來自我們制程中的創新。
展望未來,收益將來自工藝和封裝方面的創新。我們的工藝將繼續實現歷史性的密度改進,而我們的 2D 和 3D 堆疊技術為架構師和設計師提供更多工具來增加每個設備的晶體管數量。
當我們期待諸如 High NA、RibbonFET、PowerVia、Foveros Omni 和 Direct 等創新技術時,我們看到創新沒有盡頭,因此摩爾定律也沒有盡頭。
總而言之,當我們考慮所有各種工藝和先進封裝創新時,有許多選擇可以繼續按照客戶要求的節奏將每個器件的晶體管數量翻倍。只有當創新停止時,摩爾定律才會停止,而英特爾在工藝、封裝和架構方面的創新繼續有增無減。
到 2030 年,我們仍然堅定地希望在單個設備中提供大約 1 萬億個晶體管。


