前言:
近年來摩爾定律增速不斷放緩,而新型應用對高效節能芯片的要求越來越強烈,半導體業界正在積極探索解決方案,包括3D封裝等技術。
發展技術才是硬道理
作為全球先進芯片生產廠商,三星已經在制程工藝上取得了很大的成功。近日,三星又對外宣布其全新的芯片封裝技術X-Cube,稱該技術可以使封裝完成的芯片擁有更強大的性能以及更高的能效比。目前現有的芯片都是2D平面堆疊的,隨著芯片數量的增多,占用的面積越來越大,不利于提高集成度。關于3D芯片封裝,就是將芯片從平面堆疊變成了垂直堆疊,類似搭積木那樣一層層疊加,減少了芯片面積,提高了集成度。
衡量一個芯片封裝技術先進與否的重要指標是:芯片面積與封裝面積之比,這個比值越接近1越好,封裝時主要考慮的因素:
①芯片面積與封裝面積之比,為提高封裝效率,盡量接近1:1。
②引腳要盡量短以減少延遲,引腳間的距離盡量遠,以保證互不干擾,提高性能。
③基于散熱的要求,封裝越薄越好。

先進封裝技術受到熱捧
目前業界領頭羊都在3D封裝技術上面努力著,在三星推出X-Cube時,全球主要的三家半導體代工廠均已經擁有3D或2.5D的封裝技術了。前有臺積電的CoWoS,Intel的Foveros,現在三星也公布了自家的3D封裝技術X-Cube。顯而易見的是,未來我們買到的電子產品中,使用3D封裝技術的芯片比例會越來越高。
臺積電的CoWoS封裝是一項2.5D封裝技術,它可以把多個小芯片封裝到一個基板上,這項技術有許多優點,但主要優勢是節約空間、增強芯片之間的互聯性和功耗降低,AMD的Fury和Vega系列顯卡就是使用這一技術把GPU和HBM顯存封裝在一起的,NVIDIA的高端Tesla計算卡也是用這種封裝。
英特爾Foveros3D堆疊封裝技術,可以通過在水平布置的芯片之上垂直安置更多面積更小、功能更簡單的小芯片來讓方案整體具備更完整的功能。官方表示,除了功能性的提升之外,Foveros技術對于產業來說最吸引的地方在于他可以將過去漫長的重新設計、測試、流片過程統統省去,直接將不同IP、不同工藝的各種成熟方案封裝在一起,從而大幅降低成本并提升產品上市速度。

X-Cube 3D可大規模投產
而三星的X-Cube意為拓展的立方體。不同于以往多個芯片平行封裝,全新的X-Cube3D封裝允許多枚芯片堆疊封裝,使得成品芯片結構更加緊湊。而芯片之間的通信連接采用了TSV技術,而不是傳統的導線。
據三星介紹,目前該技術已經可以將SRAM存儲芯片堆疊到主芯片上方,以騰出更多的空間用于堆疊其他組件,目前該技術已經可以用于7nm甚至5nm制程工藝的產品線,也就是說離大規模投產已經十分接近。
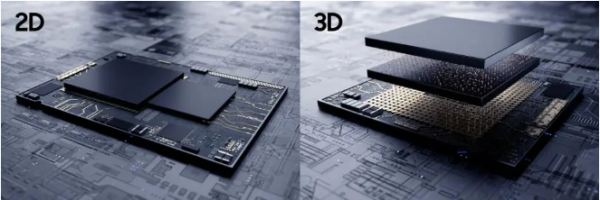
三星封裝將發展更多領域
三星表示,TSV技術可以大幅減少芯片之間的信號路徑,降低功耗的同時提高了傳輸的速率。該技術將會應用于最前沿的5G、AI、AR、HPC、移動芯片已經VR領域,這些領域也都是最需要先進封裝工藝的地方。
至于芯片發展的路線,三星與各大芯片廠商保持一致,將會跳過4nm的制程工藝,直接選用3nm作為下一代產品的研發目標。目前三星計劃和無晶圓廠的芯片設計公司繼續合作,推進3D封裝工藝在下一代高性能應用中的部署。

結尾:
無論從哪個層面來看,封裝技術在很大程度上都能夠成為推動摩爾定律繼續向前發展的第二只輪子。這也讓整個半導體行業開辟了全新的發展路徑和空間。

