ICEP 2021日本規模最大的電子封裝國際線上會議中,矽品王愉博博士分享系統級封裝SiP在5G mmWave毫米波的應用,詳解全球5G市場趨勢,探討天線封裝(AiP)特性以及如何設計性能良好的AiP封裝。

5G包含Sub-6Ghz和mmWave兩大頻段,具有帶寬更高、連接更廣以及延遲性更低等特性。其中mmWave主要運用于大帶寬移動數據(如高清視頻、云游戲),特定領域(如體育場館、展館等)大帶寬數據傳輸以及專網垂直應用(如智能汽車與智能工廠)等。

系統級封裝SiP打破傳統封裝領域的界限,重組產業生態鏈,而5G是系統級封裝SiP迅速發展的主推動力。在Sub-6Ghz頻段,系統級封裝SiP可節省大量空間;在mmWave頻段,系統級封裝SiP可整合所有的元件,使傳輸距離變短,減少路徑損耗。王博士指出,在通訊上,手機和車用雷達領域,基板尺寸小于30mm×30mm,基板上的線寬和線距小于20μm,可采用天線封裝(AiP)達到縮小尺寸、性能最優化的效果;在高速計算上,AI、機器智能(MI)和云端等領域,基板尺寸可達90mm×90mm,更適合運用2.5/3D封裝和扇出型封裝(Fan Out)、BGA封裝及大尺寸的倒裝芯片封裝(Flip Chip)等封裝技術。
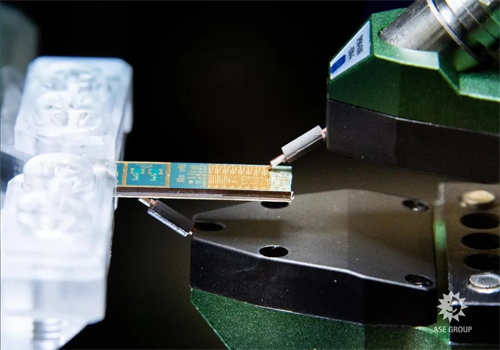
天線封裝AiP
天線封裝AiP技術是通過材料與工藝將天線集成在帶有芯片的封裝內,同時通過系統級封裝SiP技術予以實現。天線的大小受波長與頻率的影響,波長越短,頻率越高則天線就越小。天線封裝AiP為5G mmWave提供良好的天線解決方案,使天線集成在基板上,尺寸小于2mm,充分發揮天線的性能好、小型化和性價比高等優勢。王博士以智能手機為例,分析智能手機用到多個天線封裝AiP模塊,其中射頻前端模塊(RF FEM)、WiFi 6E、藍牙、電源管理集成電路(PMIC)及AP/BB等都可運用系統級封裝SiP技術使尺寸縮小30-50%,系統設計更輕薄短小,大幅縮小系統模塊的體積,使訊號更穩定,功能更強。天線板主要有兩種設計,一種是上下多層貼片天線,一種是單層貼片天線,多層貼片天線具有更好的頻率帶寬和增益帶寬,效率更高,被廣泛地應用在5G和無線千兆比特(WiGig)的天線封裝AiP,而單層貼片天線主要應用于傳感器和雷達等。影響天線性能的主要因素是基板的材料和厚度、介電常數(DK)和介質損耗(DF)。當使用的基板越厚,天線封裝AiP性能越出色。此外,介電常數是隨著頻率變化的,頻率上升則介電常數值會降的更低,利用低介電常數(DK)可以提高天線性能,同時可以利用低介質損耗(DF)來增加天線效率。

日月光毫米波天線量測實驗室
目前全球5G mmWave仍面臨諸多挑戰,例如信號損耗高、應用需求不足等,因此未來5G mmWave對系統級封裝SiP技術的需求將持續擴大,對天線封裝AiP等高頻部分的結構、材料、電性能和散熱等要求不斷提高,同時成本也將逐步降低。日月光集團研發于2018年建置5G mmWave高頻天線、射頻元件特性封測的整體量測環境室(Chamber),提供從模塊設計、材料使用、模擬及量測的一元化服務。同時整合旗下不同工廠在基板、材料、封裝與測試等方面的實力,進一步強化日月光在產業鏈的深度布局與全面積累,全方位滿足客戶需求,保持全球前瞻性創新發展。
關于ICEP
ICEP是日本規模最大的電子封裝國際會議,自2001年成立以來,每年舉辦35場技術論壇,吸引來自全球約400名參會者。ICEP由JIEP、IEEE EPS日本分會和iMAPS聯合舉辦,技術論壇涵蓋先進封裝、設計、建模與可靠性、新興技術、無線與組件、材料與工藝、光電、電力電子集成及熱管理等,在日本享有盛譽。


