2月17日消息,ASML已經向Intel交付第一臺高NA EUV極紫外光刻機,將用于2nm工藝以下芯片的制造,臺積電、三星未來也會陸續接收,可直達1nm工藝左右。
那么之后呢?消息稱,ASML正在研究下一代Hyper NA(超級NA)光刻機,繼續延續摩爾定律。
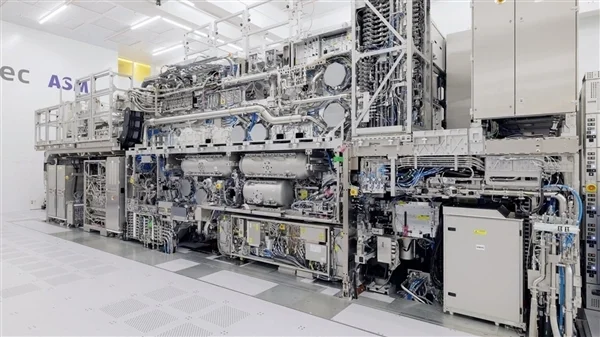
ASML第一代Low NA EUV光刻機只有0.33 NA(孔徑數值),臨界尺寸(CD)為13.5nm,最小金屬間距為26nm,單次曝光下的內連接間距約為25-30nm,適合制造4/5nm工藝。
使用雙重曝光,可將內連接間距縮小到21-24nm,就能制造3nm工藝了,比如臺積電N3B。
第二代EUV光刻機提高到了0.55 NA,臨界尺寸縮小到8nm,金屬間距最小約為16nm,可制造3-1nm,比如Intel就透露會在1.4nm節點上首次使用。
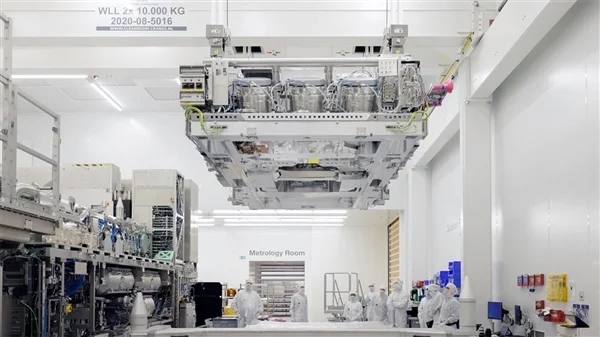
ASML CTO Martin van den Brink在接受采訪時確認,ASML正在調查開發Hyper NA技術,繼續推進各項光刻指標,其中NA數值將超過0.7,預計在2030年左右完成。
它表示,這種新型EUV光刻機適合制造邏輯處理器芯片,相比高NA雙重曝光成本更低,也可用來制造DRAM內存芯片。
ASML已披露的數據顯示,低NA光刻機的成本至少1.83億美元,高NA光刻機更是3.8億美元起步。

根據微電子研究中心(IMEC)的路線圖,2030年左右應該能推進到A7 0.7nm工藝,之后還有A5 0.5nm、A3 0.3nm、A2 0.2nm,但那得是2036年左右的事兒了。
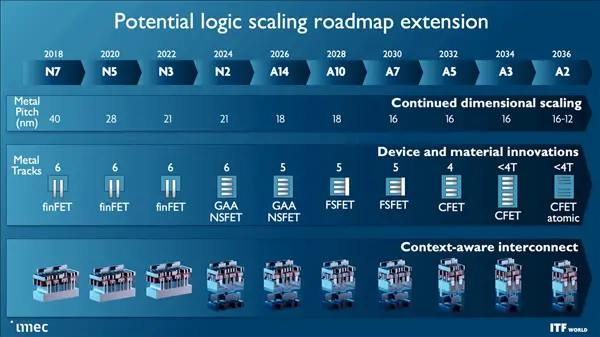

本站內容除特別聲明的原創文章之外,轉載內容只為傳遞更多信息,并不代表本網站贊同其觀點。轉載的所有的文章、圖片、音/視頻文件等資料的版權歸版權所有權人所有。本站采用的非本站原創文章及圖片等內容無法一一聯系確認版權者。如涉及作品內容、版權和其它問題,請及時通過電子郵件或電話通知我們,以便迅速采取適當措施,避免給雙方造成不必要的經濟損失。聯系電話:010-82306118;郵箱:aet@chinaaet.com。

